Страница: 14/18
Все сказанное в данном разделе касается самых основных физических или приборных эффектов, связанных с травлением поверхности ионным пучком и проблемой распыления ионами без искажения профиля концентрации. Поэтому многое из сказанного относится к любому из методов анализа поверхности с использованием ионного травления.
Измерение профилей методом ВИМС сводится к регистрации сигнала вторичных ионов интересующего нас элемента как функции времени распыления. В случае однородной матрицы это время, выполнив соответствующие градуировочные измерения (распыление пленки известной толщины, измерения глубины кратера, коэффициентов распыления и т.д.), можно пересчитать в глубину залегания элемента. Изменение интенсивности вторичных ионов не всегда отражает относительное изменение концентрации элемента; поэтому нужна осторожность при интерпретации глубинных профилей, особенно вблизи самой поверхности, т. е. когда глубина меньше RP+2DRP, а также пленок, состоящих из различающихся по составу слоев, или матриц с неоднородным распределением следов элементов, которые способны даже при малой концентрации сильно повлиять на вторично-эмиссионные свойства образца. В последнем случае для получения результатов, отражающих реальную ситуацию, следует обработать измеренные профили так, как это делается при количественной интерпретации интенсивности вторичных ионов. Если это невозможно, нужно попытаться по крайней мере проградуировать интенсивность вторичных ионов изучаемого элемента по одному или нескольким элементам, равномерно распределенным в пленке. В общем абсолютная интенсивность вторичных ионов дает прямую информацию о
распределении элемента по глубине лишь при малых концентрациях примеси в аморфной или монокристаллической матрице с равномерно распределенными основными компонентами и лишь при глубинах под поверхностью, превышающих 50 А.
Пригодность метода ВИМС для определения глубинного профиля наряду с его высокой чувствительностью к большинству элементов делает его весьма привлекательным как метод изучения тонких пленок, ионной имплантации и диффузии. Факторы, существенные при проведении глубинного анализа методом ВИМС, могут быть разделены на две группы: приборные и обусловленные особенностями сочетания ион - матрица.
Приборные факторы, влияющие на разрешение по глубине при измерении профилей концентрации
Получить при методе ВИМС надежные сведения о глубинном профиле можно лишь в том случае, если поддерживается постоянная интенсивность тока первичных ионов и обеспечивается однородность плотности тока пучка в той части поверхности, из которой в масс-анализатор отбираются вторичные частицы. В стационарном сфокусированном ионном пучке плотность тока, падающего на образец, не постоянна по сечению пучка, а следовательно, и распыление поверхности в этих условиях не может быть равномерным. Если зона, из которой поступает информация, охватывает все сечение первичного пучка, то вклад в сигнал ионов с краев кратера будет искажать профиль концентрации элемента в приповерхностном слое (фиг. 13).
Ошибки такого рода устраняются в ВИМС разными способами в зависимости от конструкции прибора. В устройствах, в которых не предусмотрена возможность определять распределение элемента по поверхности, обычно расфокусируют пучок так, чтобы его сечение было больше анализируемой области или вырезают при помощи диафрагмы из расфокусированного пучка определенный участок с однородной плотностью тока. Иногда на поверхности мишени помещают тонкую маску из
материала, не дающего вторичных ионов, близких к анализируемым, которая ограничивает вторичную ионную эмиссию из областей неоднородной плотности первичного пучка.
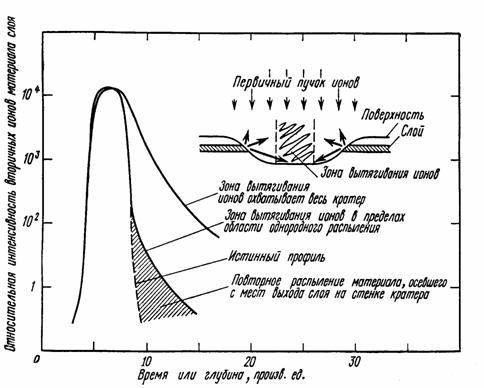
Фиг.13. Переменный профиль концентрации в приповерхностном слое с указанием различных приборных факторов, которые приводят к искажению профиля по
Реферат опубликован: 8/12/2006