Страница: 13/18
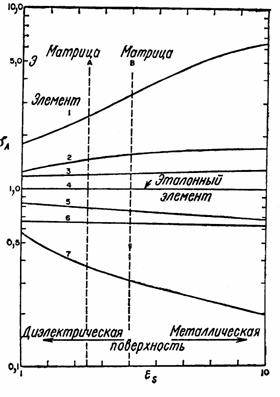
Фиг.12. Зависимость коэффициентов jА относительной чувствительности к разным элементам от типа поверхности образца[1].
При определении величины eS, следует отдавать предпочтение тем способам, которые основаны исключительно на информации, содержащейся в спектрах вторичных ионов или отношениях величин пиков этих ионов в спектре для неизвестного образца, т.е. информации типа отношений интенсивностей ионов М2+/М+, МО+/М+, МN+/М+ (иди любых других), зависящих от eS, но не зависящих от концентрации элементов. Кроме того, величину eS, можно рассчитать исходя из отношений ионных сигналов и концентраций двух или более компонентов, для которых jА/jА’ зависит от матрицы. Подобный метод пригоден при обнаружении следов элементов в хорошо известной матрице. И наконец, можно просто выбрать величину eS руководствуясь исключительно аналитическим опытом и интуицией. Такой способ не так уж плох, как могло бы показаться. По крайней мере исключаются грубые ошибки (фиг. 12).
Единственный набор коэффициентов чувствительности позволяет определять концентрации с ошибкой не более чем в 2 раза для большинства элементов в ряде весьма различающихся матриц. Любая модель, которая вводит в коэффициенты относительной чувствительности поправку на влияние матрицы, может лишь улучшить результаты. Привлекательные стороны описанного выше подхода таковы: простая модель, которую можно использовать в любом приборе независимо от каких- либо теоретических или физических констант и которая основывается исключительно на эталонах и измерениях в данном приборе.
Выше основной упор мы делали на анализ объемного состава твердых тел, а не тонких поверхностных слоев. Поскольку объемный состав твердых мишеней можно задать достаточно точно, они и служат эталонами для проверки количественных моделей. Для поверхностных пленок толщиной менее 50 А эталоны либо вообще невозможно, либо очень трудно изготовить.
Следовательно, количественные данные для внешних 50 А можно получить лишь так же, как и в случае объемного образца, когда нет эталона.
Глубинные профили концентрации элементов
При исследовании распределения того или иного элемента по слоям, параллельным поверхности образца, для обнажения глубоколежащих слоев твердого тела in situ в большинстве методов анализа поверхности (не только ВИМС) применяют распыление ионами. При этом разрешение по глубине, обеспечиваемое выбранным методом анализа поверхности, оказывается не очень существенным, поскольку разрешение будет определяться в основном перемешиванием в приповерхностных слоях и другими процессами, сопровождающими травление поверхности.
Разрешение по глубине, обеспечиваемое при данном методе определения профилей концентрации, можно характеризовать тем уширением профиля тонкого поверхностного слоя или резкой границы раздела между двумя различными материалами, которое обусловлено самим процессом измерения. Если толщина слоя (или глубина залегания границы раздела) превышает примерно 2RP то из-за различных факторов, вызывающих уширение измеряемого профиля концентрации (приборных и ионно-матричных эффектов), распределение для тонкого слоя оказывается близким к нормальному распределению со среднеквадратичным отклонением sR. За разрешение по глубине можно принять величину sR для этого распределения. Если слой толстый, то среднеквадратичное отклонение sМ экспериментально наблюдаемого (измеренного) профиля связано с sR и sТ соотношением s2М = s2R+s2Т , где sТ - среднеквадратичное отклонение истинного распределения слоя. При sМ >>sТ , например в случае тонкого слоя, величина sR приблизительно равна разрешению sR метода по глубине.
Если принять, что измеренный профиль тонкого слоя описывается нормальным распределением, то можно рассмотреть и случай уширения границы раздела, и его связь с разрешением по глубине. Это разрешение можно вычислить по профилю ступенчатого изменения концентрации (ширина ступени >> sR), когда форма истинного края ступени похожа на кривую интегрального нормального распределения со среднеквадратичным отклонением st. Если концентрация изменяется резко (st~0), то разрешению по глубине sR соответствует величина sm, половина расстояния между глубинами, отвечающими 84 и 16% измеренной на опыте высоты ступени. В случае граничной области со значительной собственной шириной (т. е. со значительным st) разрешение по глубина дается формулой sR =(s2m -s2t)1/2, причем нужно учитывать ошибки в величинах sm и st. Случай профиля слоя с существенным sT можно рассчитать аналогично.
Реферат опубликован: 8/12/2006