Страница: 18/18
Методом ВИМС проводится анализ двоякого рода: определение общего состава в объеме твердого тела и определение состава в отдельных его точках (т. е микрообластях диаметром менее 25 мкм). Микроанализ методом ВИМС проводился для определения следов различных элементов, содержащихся в тех или иных зернах минералов, изотопического анализа РЬ in situ в ореоле радиоактивных включений (диаметром 1 - 2 мкм), элементного анализа взвеси и определения возраста некоторых фаз в минералах по отношению 207Pb/206Pbи рубидиево-стронциевым методом. Анализ активных газов (таких, как Н2, N2, О2) в металлах этим методом сопряжен с известными трудностями.
Заключение
Пока что нет такого метода, который полностью удовлетворял бы всем запросам всех исследователей, имеющих дело с поверхностью. Метод ВИМС не является исключением в этом отношении, но он занимает особое положение в области анализа состава объема и поверхности твердого тела, т. к. в ряде других отношений с ним не могут сравниться никакие другие методы. Высокочувствительность к большинству элементов, возможность регистрации атомов с малыми Z и изотопического анализа, высокое разрешение по глубине при измерении профилей концентрации и возможность изучения распределения элементов по поверхности делают ВИМС методом трехмерного анализа изотопного и следового состава твердого тела (фиг. 14).
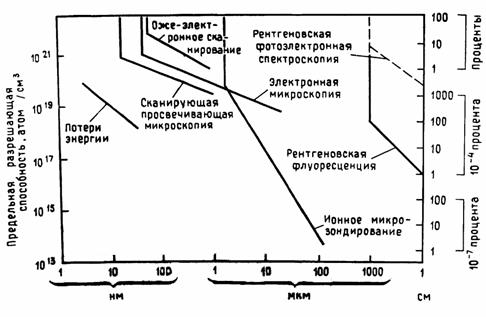
Фиг.14. Влияние анализируемой площади на предельную разрешающую способность[2].
Многие задачи физики поверхности могут быть решены качественными или полуколичественными методами, поэтому, не очень высокая точность количественных оценок, обеспечиваемая методом ВИМС, с лихвой компенсируется той ценной качественной информацией, которую он дает. ВИМС уже оказал большое влияние на микроанализ твердых тел в направлениях, имеющих как фундаментальное, так и прикладное значение. Дальнейшее развитие метода ВИМС должно быть направлено, главным образом, на решение проблемы количественного анализа и отыскания путей повышения его точности.
Список литературы
1. Мак-Хью И.А. Вторично-ионная масс-спектрометрия: В кн. Методы анализа поверхности./Пер с англ. - М.: Мир, 1979. - с. 276-342.
2. Броудай И., Мерей Дж. Физические основы микротехнологии: Пер. с англ. - М.: Мир, 1985. - 496 с.
3. Технология СБИС: В 2-х кн. Пер. с англ./Под ред. С. Зи. - М.: Мир, 1986. - 453 с.
4. Черепин В.Т., Васильев М.А. Методы и приборы для анализа поверхности материалов: Справочник. - Киев: Наукова Думка, 1982. - 400 с.
5. Фелдман Л., Майер Д. Основы анализа поверхности и тонких пленок./Пер. с англ. - М.: Мир, 1989. - 342 с.
6. Добрецов Л.Н., Гомоюнова М.В. Эмиссионная электроника. - М.: Наука, 1966. - 564 с.
7. Векслер В.И. Вторичная ионная эмиссия металлов. - М.: Наука, 1978. - 240 с.
Реферат опубликован: 22/03/2008