Страница: 5/12
2.2. ФИЗИКА ПРЕОБРАЗОВАНИЯ ЭHEPГИИ В ДИОДНОМ ОПТРОНЕ
Рассмотрение процессов преобразования энергии в оптроне требует учитывать квантовую природу света. Известно, что электромагнитное излучение может быть представлено в виде потока частиц - квантов (фотонов), энергия. каждого из которых определяется соотношением;
Eф=hn=hc/nl (2.1)
где h - постоянная Планка ;
с - скорость света в вакууме ;
n - показатель преломления полупроводника ;
n, l - частота колебаний и длина волны оптического излучения.
Если плотность потока квантов (т. е. число квантов, пролетающих через единицу площади в единицу вpeмени) равна Nф, то полная удельная мощность излучения составит:
Pф= Nф Eф (2.2)
и, как видно из (2.1), при заданном Nф она тем больше, чем короче длина волны излучения. Поскольку на практике заданной бывает Pф (энергетическая облученность фотоприемника), то представляется полезным следующее соотношение
Nф = Pф/ Eф=5![]() 1015 l Pф (2.3)
1015 l Pф (2.3)
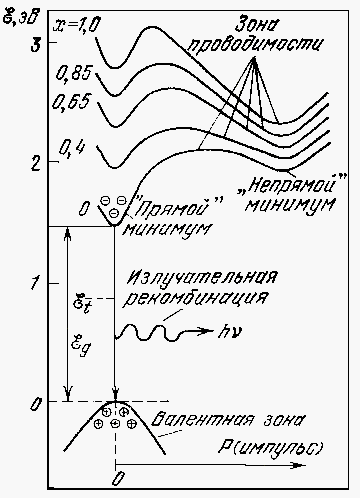
Рис.2.1. Энергетическая диаграмма прямозонного полупроводника (на примере тройного соединения GaAsP).
где Nф, см-2![]() с-1; l, мкм; Pф, мВт/см.
с-1; l, мкм; Pф, мВт/см.
Механизм инжекционной люминесценции в светодиоде состоит из трех основных процессов: излучательная (и безызлучательная) рекомбинация в полупроводниках, инжекция избыточных неосновных носителей заряда в базу светодиода и вывод излучения из области генерации.
Рекомбинация носителей заряда в полупроводнике определяется прежде всего его зонной диаграммой, наличием и природой примесей и дефектов, степенью нарушения равновесного состояния. Основные материалы оптронных излучателей (GaAs и тройные соединения на его основе GaA1As и GaAsP) относятся к прямозонным полупроводникам т.е. к таким, в которых разрешенными являются прямые оптические переходы зона-зона (рис.2.1.). Каждый акт рекомбинации носителя заряда по этой схеме сопровождается излучением кванта, длина волны которого в соответствии с законом сохранения энергии определяется соотношением
lизл[мкм] =1,23/ Eф[эB] (2.4)
Следует отметить, Что имеются и конкурирующие безызлучательные - механизмы рекомбинации . К числу важнейших из них относятся:
1. Рекомбинация на глубоких центрах. Электрон может переходить в валентную зону не прямо, а через те или иные центры рекомбинации, образующие разрешенные энергетические уровни в запрещенной зоне (уровень Et на рисунке 2.1).
2. Оже-рекомбинация (или ударная). При очень высоких концентрациях свободных носителей заряда в полупроводнике растет вероятность столкновения трех тел, энергия рекомбинирующей электронно-дырочкой пары при этом отдается третьему свободному носителю в форме кинетической энергии, которую он постепенно растрачивает при соударениях с решеткой.
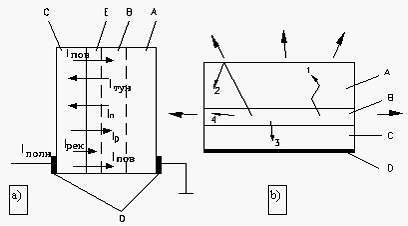
рис.2.2. Электрическая (a) и оптическая (b) модели светодиода.
A - оптически “прозрачная” часть кристалла; B - активная часть кристалла; C -“непрозрачная” часть кристалла; D - омические контакты; E - область объемного заряда.
Относительная роль различных механизмов рекомбинации описывается введением понятия внутреннего квантового выхода излучения hint, определяемого отношением вероятности излучательной рекомбинации к полной (излучательной и безызлучательной) вероятности рекомбинации (или, иначе, отношением числа генерированных квантов к числу инжектированных за то же время неосновных носителей заряда). Значение hint является важнейшей характеристикой материала, используемого в светодиоде; очевидно, что 0![]() hint
hint![]() 100%.
100%.
Создание избыточной концентрации свободных носителей в активной (излучающей) области кристалла светодиода осуществляется путем инжекции их р - n-переходом, смещенным в прямом направлении.
“Полезной” компонентной тока, поддерживающей излучательную рекомбинацию в активной области диода, является ток электронов In (рис.2.2,а), инжектируемых р - n-переходом. К “бесполезным” компонентам прямого тока относятся:
1. Дырочная составляющая Ip, обусловленная инжекцией дырок в n-область и отражающая тот факт, что р - n-переходов с односторонней инжекцией не бывает, Доля этого тока тем меньше чем сильнее легирована n-область по сравнению с р-областью.
Реферат опубликован: 23/11/2008